

デモ測定に関しまして
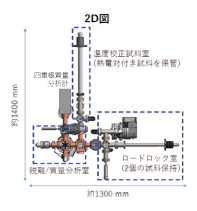
試料導入室を備えたスタンドアロンの3室構成のシステム(右図)を デモ測定機として準備しております。
本計測は、大気中での水分吸着に敏感な可能性がありますので、試料の導入方法や測定内容については相談して進めさせていただきます。
こちらよりお問い合わせください。
製品概要
微小な基板や薄膜中に含まれる水素の検出を、熱脱離法により行う装置です。水素固溶が少ないBeCuチャンバーを使用するとともに、赤外レーザーを使用し試料基板のみを効率的に加熱することにより、加熱中の水素のバックグランドの増加を抑え、試料からの脱離水素を高感度で測定できる装置です。
また、検出には四重極質量分析器を使用しているため、水素以外の脱離物質についても分析が可能です。
本装置の開発は第103回市村清新技術財団新技術開発助成により推進され、東京工業大学細野研究室との産学連携製品です。
特長
- 高感度水素検出
- レーザー加熱による非接触温度制御
主な用途
- 半導体基板中の低濃度水素の検出
- 薄膜中に混入した水素の検出
- 微小試料中の不純物元素の熱脱離検出
- 吸収・吸着の結合状態の判定
装置原理
- 赤外加熱で局所加熱
- 放射温度計で温度計測・制御
- BeCuチャンバーで低水素バックグランド
- オリフィス設置で高感度化
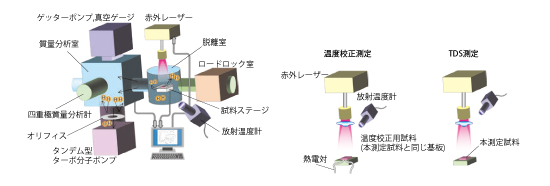
測定データ
Hイオン注入Si基板の熱脱離実験結果
1:1回目と2回目加熱の連続TDS結果
2:異なるイオン注入濃度Si基板の熱脱離実験結果
3:強度積分値と水素イオンの検量線グラフ
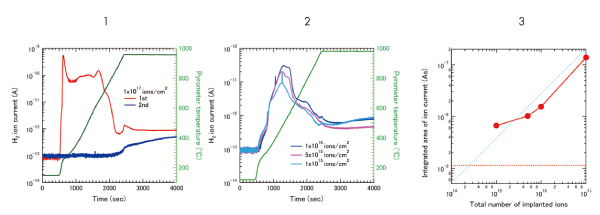
Si基板の加熱制御結果
1:昇温速度制御可能
2:広範囲にわたる 高い温度制御精度

超高感度熱脱離分析装置 HEMTO-TDS 仕様
水素の検出限界
| イオン電流 | 1×10-13Aまで検出可能 |
|---|---|
| 1×1015ion.cm2の水素イオン注入基板まで検出可能 | |
| 5×1016個/cm3, 1/100万程度の濃度の水素原子を検出 | |
| 加熱方式 | 赤外レーザー加熱(983nm) |
| 温度制御 | 放射温度計によるPID制御 (放射率は熱電対付き温度校正用基板で校正) |
| 温度範囲 150℃~1000℃ | |
| 昇温速度 10℃/min~100℃/minで任意設定 | |
| 試料サイズ | 10mm×10mm |
| 質量分析範囲 | 1~100 amu |
| 更新日 | 更新内容 | サイズ | ダウンロード |
|---|



